原文链接:http://www.mems.me/mems/foundry_201303/546.html
享誉世界的MEMSCAP MUMPs(多用户共享MEMS工艺)是一种成熟的MEMS工艺商业模式。自1992年起一直稳定的运作,至今已经完成了80多个完整工艺,为数百个客户提供制造服务。罕王微电子引入MUMPs工艺为国内企业进行代工服务。
引言
制造技术是将设计转化为物理器件的关键,一个MEMS设计转化为物理器件会涉及数十道加工步骤,MEMS加工源于集成电路工艺,可以分享很多共同的加工步骤和设备,例如薄膜生长的沉积技术,扩散和注入技术,干法和湿法腐蚀,光刻,金属化等。但由于MEMS器件往往具有微型的机械结构,需要采用特殊的工艺和设备,如LIGA工艺、晶圆键合等,生产设备以及相关配套设施投入成本巨大,因此需要MEMS代工厂为初创设计公司提供完善的制造服务。
享誉世界的MEMSCAP MUMPs(多用户共享MEMS 工艺)是一种成熟的MEMS工艺商业模式。自1992年起一直稳定的运作,至今已经完成了80多个完整工艺,为数百个客户提供制造服务。MEMS新产品的开发一般需要经历需求分析,样品开发,优化,成果转化,量产几个过程,采用MUMPs模式,用户可以根据标准结构和工艺流程来定义新产品的模型,以最小的优化次数完成从实验室到批量生产的转化,从而大幅的节约开发成本,降低风险。
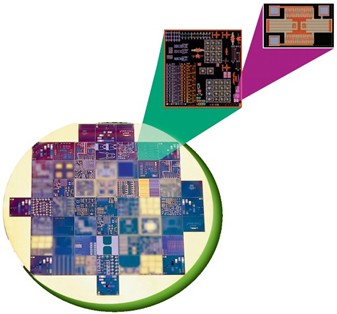
多用户设计共享的MUMPs晶圆
罕王微电子(辽宁)有限公司(以下简称罕王微电子)作为MEMSCAP中国区的合作伙伴,将为客户提供MUMPs设计和制造服务。帮助客户以最短的时间,最低的成本完成MEMS芯片的样品设计,实现样品设计验证与规模生产过程的无缝连接,尤其针对科研院所,可以根据需要仅仅购买几个芯片单元,完成创意验证和人才培养的目标。

罕王MEMS产品开发流程
MUMPs工艺流程
MUMPs提供三种工艺流程:Poly MUMPs、Metal MUMPs和SOI MUMPs。
Poly MUMPs工艺流程的创立,为采用标准工艺流程实现器件的性能并量产提供了清晰的思路,由于其在在朗讯和前OMM的原型设计和量产中成功应用,以及数十年的运营,已经成为目前工艺界最成功的MEMS MPW服务。在上个世纪90年代,Poly MUMPs就已经成为制作创新性器件并形成知识产权的主要方法,今天这个作用得到了更大的扩展,支持更为广泛的首创设计。目前可用Poly MUMPs完成的器件包括:声学器件(麦克风)、加速度计、微流体器件和显示器件等。
SOI MUMPs是在MEMSCAP的可变光衰减器的工艺流程基础上,经过修改而成的,并于2003年开始面向市场。SOI晶圆由衬底层(厚度400um)、埋氧化层和器件层构成,其中器件层有10 um和25 um两种厚度可供选择,并且SOI晶圆可以进行双面光刻。SOI MUMPs就是以这种SOI晶圆作为基底,其工艺可以完成从两侧刻蚀到埋氧层来制作光通路,沉积两层金属一层作为焊盘一层作为反射层,其最小线宽为2 um。目前可用SOI MUMPs完成的器件包括:陀螺仪、光学器件和显示器件等。
Metal MUMPs是在MEMSCAP的微型继电器的工艺流程基础上,经过修改而成的,并于2003年开始面向市场。Metal MUMPs的最小线宽为5um,采用Metal MUMPs的三种工艺:准LIGA工艺、厚金属电镀工艺和体表面硅工艺可以在多晶硅和氮化硅薄膜上制作18~22um厚度的镍金属结构,用作结构材料和电互连层。目前可用Metal MUMPs完成的器件包括:微型继电器、微流体器件、磁开关和RF器件等。
下面详细介绍Poly MUMPs工艺流程:
Poly MUMPs工艺共采用8层掩膜板形成7层结构,由采用表面硅和体硅工艺的3层多晶硅层,2层牺牲层及1层金属层构成,其最小线宽为2微米。
(1)工艺从N型(100)晶圆开始,首先在晶圆表面沉积PSG层,然后进行重掺杂,以防止或减少载流子进入衬底,最后去除PSG层。
(2)利用LPCVD沉积600nm的低应力SiN层,用作电隔离层。
(3)利用LPCVD在SiN上沉积500nm的多晶硅薄膜Poly 0,然后进行第一次光刻,做图形转移,采用等离子刻蚀Poly 0。

(4)利用LPCVD沉积一层2um的PSG层,1050℃退火1小时。该PSG层是第一层氧化牺牲层,最后会被去除,以释放Poly 0。

(5)在第一层牺牲层上做DIMPLES光刻(第二次),DIMPLES深度为750nm,然后利用RIE刻蚀PSG层。

(6)做Anchor 1的光刻(第三次),然后利用RIE刻蚀PSG层,目的是为了做Ploy 1的固定结构。
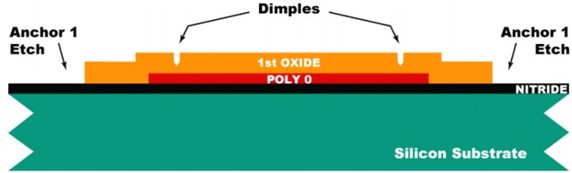
(7)采用LPCVD沉积2um厚度的Ploy 1层,然后利用LPCVD沉积一层200nm的PSG层,1050℃退火1小时。Ploy 1上下两层的PSG在退火中扩散进入Ploy 1层,可以显著减小应力。
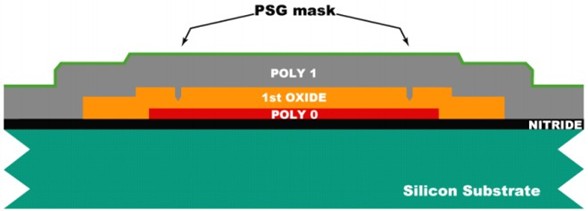
(8)接下来在PSG层上做光刻(第四次),PSG层实际上是被做成硬掩膜版。接下来刻蚀Ploy 1层,最后去除光刻胶与PSG层。

(9)沉积第二层PSG牺牲层,厚度为750nm,最后进行退火。
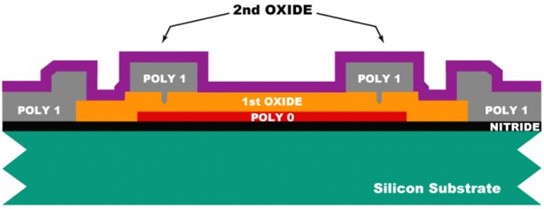
(10)对Oxide 2进行两次不同的光刻,Poly 1 - Poly 2 - Via光刻(第五次),目的是使Ploy 1与Poly 2连接起来。最后Oxide 2层用RIE刻蚀去除。
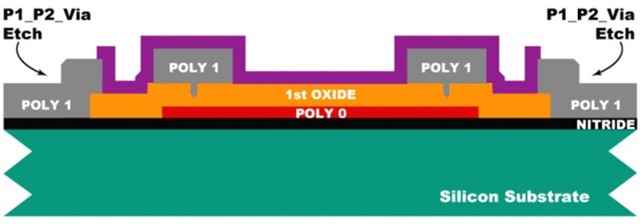
(11)进行Anchor 2光刻(第六次),这一步光刻要刻穿Oxide 2和Oxide 1两层,直接与Ploy 0连接,最后Oxide 1和Oxide 2是用RIE刻蚀去除。

(12)沉积1.5um的Poly 2层,然后在Ploy 2上沉积200nm的PSG层。与Poly 1层相同,PSG层作为扩散源与硬掩膜版两个作用。1050℃退火1小时,以减小Poly 2层的应力。
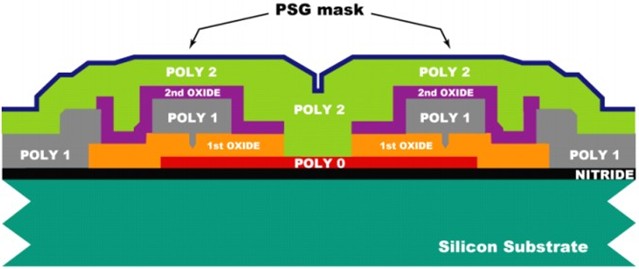
(13)对Poly 2层进行光刻(第七次),PSG层与Poly 2层分别用等离子与RIE刻蚀去除。

(14)进行金属沉积,利用Lift-off工艺(第八次),沉积0.5um的金属层。
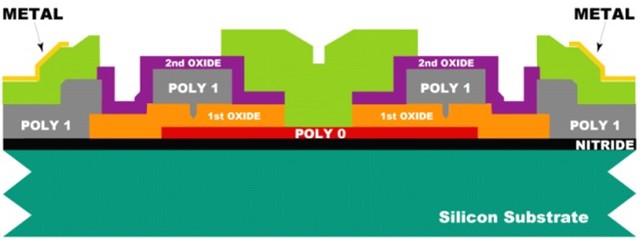
(15)没有释放的晶圆被切割、分类和运输,客户可以采用49%的HF腐蚀1.5~2分钟以释放结构,然后去离子水清洗,最后在110℃烘箱中加热10分钟,以消除粘附力。
MUMPs优势
MUMPs工艺流程具有成本低、加工制造周期短的优势。由于采用完整标准工艺流程,所以每道工艺参数及各工艺层的相关性被充分理解和详尽记录。MUMPs工艺流程支持商业客户的实用设计策略,设计者从固定的工艺流程开始,并基于此流程优化设计。这种方法将减少设计优化次数,具有更低并且是固定的开发成本,在功能实现和量产过程中减少障碍,因此优于设计优先策略。
(1)三种可选工艺流程,并可灵活组合和修改
(2)快速评估新的MEMS设计方案
(3)可以仅购买几个芯片单元,以降低原型概念验证的加工费用
(4)采用成熟的设计规则和标准的加工工艺,降低开发成本,缩短产品开发周期
(5)支持常用的CAD开发工具,快速上手
(6)使用现成的单元库,提高器件和结构的可用性