The problem of test generation
Random test generation
Deterministic algorithm for test generation for stuck at faults, enhance the deterministic engines such as static and dynamic learning
Simulation based test generation,
Test generation for other fault models such as delay faults, ATPG for path-delay faults and transition faults.
Test generation的目的是产生一系列的test vectors,来揭示chip中任何的defect。
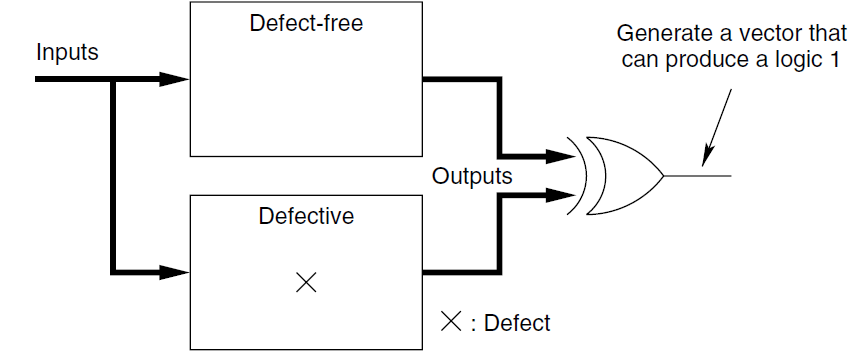
ATPG与DFT的技术发展是相辅相成的,两者有一个共同的目标便是发现chip中的defect。如果ATPG可以在现有DFT设计技术下,实现高的test coverage和小的test set,那DFT技术便不用再继续发展。
一个test vector需要保证从primary input可以control到需要的bit,同时还需要保证从primary output可以observe到需要的bit。
一个circuit中的fault,可能在logic上是equivalent的,这时test并不能区分它们,也不需要,ATPG只关心collapsed fault list。
Random test generation是一种最简单的generate vectors的方法,因为它不以specific fault为目标,所以complexity非常低,缺点是test set可能会很大,
最后的test coverage可能不是太高。在这种方式中,有些fault被检测到的概率很低,称为random-pattern resistant faults,
如果采用biasing primary input的方式来避免这个问题,每个primary input的概率确认又不容易。
所以用ATPG产生用于scan-design的pattern,一般都是deterministic的。
Memory bit-cell相比计较于stand-cell,拥有更高的density。相比较stand-cell也有更多的fault models
MBIST包括,内部的测试算法,Smatch相比较于D算法(stuck-at),pattern generated,response analysis
Self Repair

MemoryBIST实现中,通过标准的TAP接口来实现MBIST的控制。

内部的Test Algorithms:
SMarchCHKB/SMarchCHKBci/SMarchCHKBcil/SMarchCHKBvcd
Self-Repair


Repair Analysis
